对抗知识焦虑,从看懂这条开始
App 下载
芯片算力卡壳,玻璃成了破局关键材料
苹果|三星电机|芯片封装|有机基板|玻璃基板|半导体技术|前沿科技
对抗知识焦虑,从看懂这条开始
App 下载
苹果|三星电机|芯片封装|有机基板|玻璃基板|半导体技术|前沿科技
当你刷着AI生成的视频、用大模型写方案时,可能没意识到:支撑这些算力的芯片,正卡在一个看不见的瓶颈里。不是晶体管不够小,而是承载芯片的「地基」撑不住了——传统有机基板在高温下会翘曲,像被烤软的塑料片,导致芯片间的信号传输频频出错。
2026年4月,三星电机向苹果交付了一款玻璃基板样品,目标2027年后量产。这个看似普通的材料,却被行业视为突破算力天花板的钥匙。为什么一块玻璃能解决芯片的「地基危机」?这背后藏着半导体产业的一次材料革命。
你可以把芯片封装想象成盖房子:芯片是高楼,基板是地基。过去几十年,我们一直在把高楼盖得更密、更高——晶体管越做越小,芯片集成度越来越高,但地基却还是用同一种「塑料」(有机基板)。
有机基板的致命问题,是热膨胀系数和硅芯片不匹配。当AI芯片满负荷运行时,核心温度能飙升到100℃以上,有机基板会像被晒化的沥青一样膨胀变形,而硅芯片的膨胀幅度只有它的1/3。这种「伸缩不一致」会导致基板翘曲,轻则让芯片间的连线断裂,重则直接让整个封装报废。
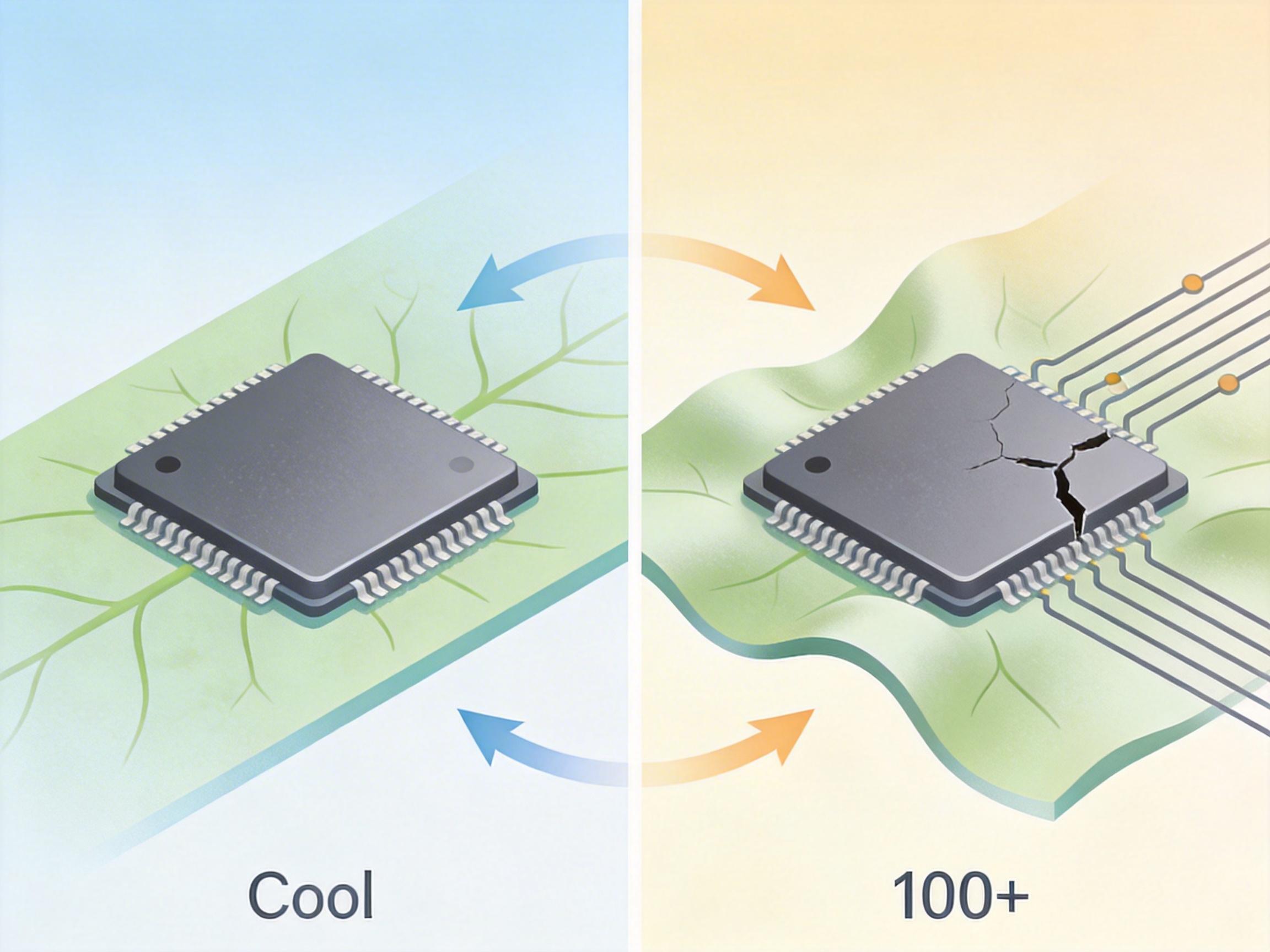
更关键的是,有机基板的表面粗糙度高,像砂纸一样,无法承载太精细的线路。传统有机基板的线宽/线距只能做到5-10微米,而AI芯片需要的是2微米以下的精细布线——相当于在一根头发丝上刻几十条跑道。
这就是当前算力的隐形天花板:不是芯片本身不够强,而是地基撑不起更密集的高楼,也铺不下更顺畅的「信息跑道」。
玻璃能解决这些问题,靠的是三个天生的优势:
第一是「热胀冷缩同步」。通过调整玻璃配方,能让它的热膨胀系数和硅芯片几乎一致,就像给芯片找了个「同频搭档」。哪怕芯片烧到100℃,玻璃基板的变形量也只有有机基板的1/10,彻底解决翘曲问题。
第二是「纳米级平整度」。玻璃基板的表面粗糙度可以控制在1纳米以下,像镜面一样光滑。这意味着它能承载2微米以下的精细布线,让芯片间的信号传输路径更短、损耗更低——相比有机基板,玻璃基板能让信号延迟降低40%,损耗减少67%。
第三是「大尺寸兼容」。玻璃可以做成600mm×600mm的大面板,比传统硅晶圆大好几倍。这就像把地基从一间房扩大到一个足球场,能同时放下更多芯片,支持大规模的Chiplet异构集成。
但玻璃基板的制造,远比做手机屏幕难。核心难点是TGV(贯穿玻璃通孔)技术:要在薄至100微米的玻璃上,钻出直径20-50微米的小孔,还要保证孔壁光滑、没有裂纹,最后用铜填满实现电气连通。
目前主流的做法是用飞秒激光先在玻璃内部「打标记」,再用氢氟酸蚀刻,能实现15:1的高纵横比(孔深是孔径的15倍)。但这个过程中,玻璃的脆性很容易导致裂纹,良率一直是个难题——当前行业良率只有75-85%,要实现大规模量产,必须突破到90%以上。

玻璃基板的产业化,已经成为全球半导体巨头的必争之地。
美国Intel早在十年前就开始布局,计划2026-2030年实现大规模应用;韩国Absolics拿到美国CHIPS法案7500万美元资助,在佐治亚州建生产线;台积电则和康宁合作,开发适配CoWoS封装的玻璃载体;国内的京东方也把玻璃基板作为核心战略,计划2027年实现高纵横比量产。
更值得关注的是,玻璃基板的普及,不仅仅是材料的替换,更是整个半导体产业链的重构。有机基板的产线无法直接复用,需要全新的自动化搬运设备、激光钻孔设备和检测系统;EDA设计工具也需要重新适配玻璃基板的特性;甚至连芯片设计思路都要改变——因为玻璃基板支持更大的封装尺寸,未来的AI芯片可能会从「单芯片」变成「多芯片集成的系统」。
被忽略的关键在于,玻璃基板的原材料几乎被康宁、肖特、AGC三家巨头垄断,他们控制着90%以上低膨胀电子级玻璃的配方和产能。这意味着,哪怕国内企业能突破制造工艺,原材料的卡脖子风险依然存在。
当我们为芯片的3nm、2nm工艺欢呼时,可能没意识到,真正的算力突破,往往藏在那些不起眼的材料里。玻璃基板的崛起,正是半导体产业从「晶体管微缩」转向「封装创新」的标志。
「算力的突破,始于地基的革命。」这句话或许能概括玻璃基板的意义。它不仅解决了当前AI芯片的「地基危机」,更重要的是,它的透明性为未来的光子集成埋下了伏笔——当芯片间的通信从电信号变成光信号,算力的天花板才会真正被打破。
当然,玻璃基板的普及还有很长的路要走:脆性问题、良率问题、原材料问题……但不可否认的是,这块小小的玻璃,已经为我们打开了一扇通往更高算力的新大门。